資料ダウンロード
半導体製造のCMP(化学機械研磨)マクロスラリー挙動解析を最適化
回転パッド上のマクロスラリー挙動の解析ソリューション
このようなニーズはありませんか?
・研磨ムラによる表面品質のばらつきで、歩留まりが低下している
・古いスラリーが残り、パーティクル欠陥が発生している
・スラリー供給が最適化できず、無駄なコストがかかっている
半導体製造において、CMP(化学機械研磨)はデバイスの品質や歩留まりを左右する重要な工程です。
ウェハ表面の平坦化を目的とするCMPプロセスでは、研磨ムラ、スラリーの供給・排出の最適化といった課題が常に存在します。
近年は特にナノレベルでの表面品質管理が求められ、スラリー挙動の詳細解析の重要性が増しています。
スラリーの流動特性や分布、研磨パッドとの相互作用を把握・最適化することで、歩留まりの向上や研磨性能の安定化が可能となります。
ソリューションの概要と特長・効果
課題
- 研磨パッド上のスラリー分布が不均一だと、研磨ムラが発生する。
- スラリーが適切に供給・回収されないと、古いスラリーが研磨面に残り、表面欠陥の原因に。
- 摩耗性能を向上させつつ、過剰研磨を防ぐ必要がある。
ソリューション
- 流体解析で表面張力や境界の動きを考慮したスラリーの流動や分布を再現。
- DEMツールで流れ場と連成し、研磨粒子の挙動を詳細に解析。
- HPCによる高速計算により、最適なパラメータを迅速に評価。
ベネフィット
- 古いスラリーを効率的に除去することで、安定した研磨品質を維持。
- 供給フローの最適化により、スラリー使用量を削減し、ランニングコストを低減。
- 摩耗性能を向上させることで、稼働時間を短縮し、不良発生率を抑制。
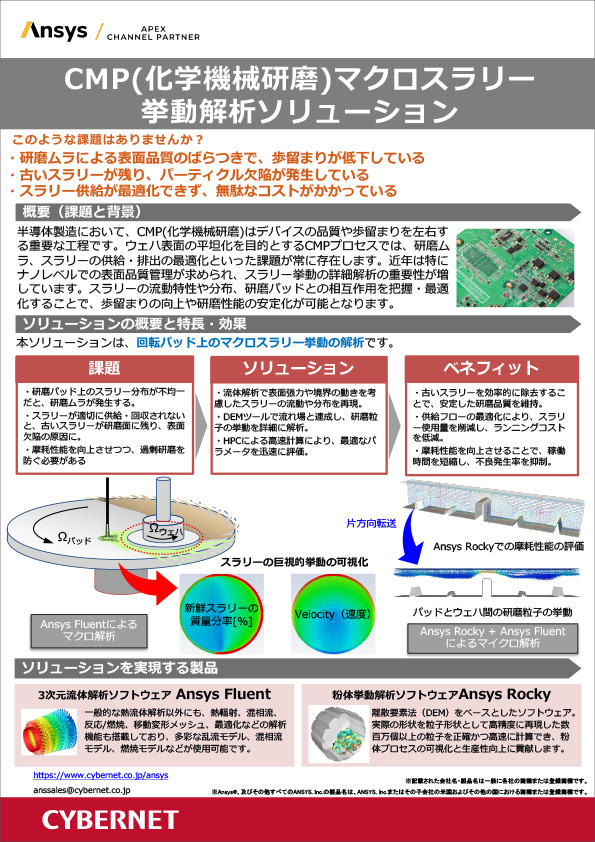
関連情報
関連する製品
MORE関連する解析事例
MORE関連する資料ダウンロード
MORE-

吸入器内の粒子挙動を可視化することで薬剤送達効率の向上へ
~薬剤送達効率向上に向けた解析~
-

医薬品バイアルの温度挙動解析による効率的な温度管理手法
~保管環境の影響把握と品質維持に向けた可視化アプローチ~
-

シリコンウェハの汚染予測で歩留まりを向上
-

CFDによる水素バーナの燃焼解析でカーボンニュートラル実現へ
CFDによる水素バーナの燃焼解析
-

Ansys Fluent ユーザー様のための熱流体解析自動化/高度化のすすめ
-

室内の熱気流ソリューション
~Ansys Fluentによる熱流体解析~
-
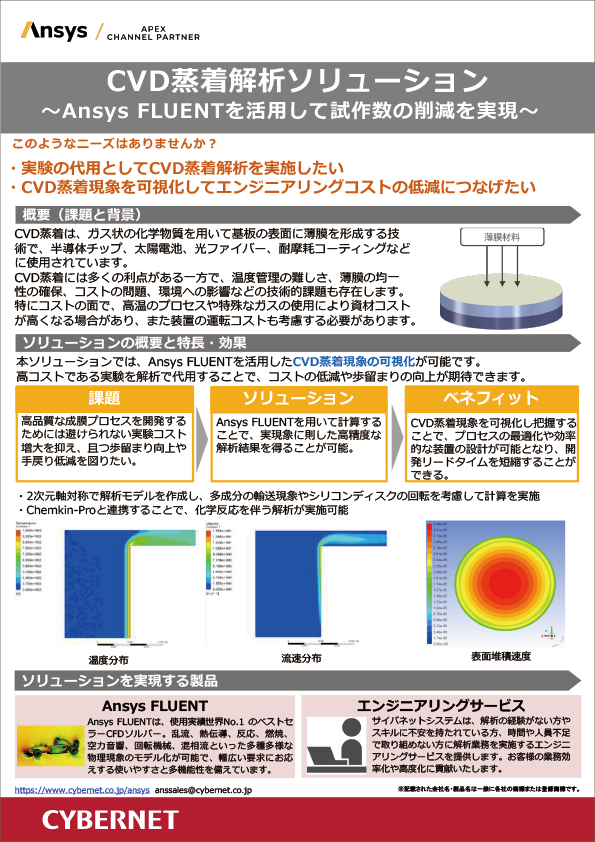
CVD蒸着解析ソリューション
~Ansys FLUENTを活用して試作数の削減を実現~
-

ウェハ洗浄解析ソリューション
~Ansys FLUENTを活用して開発期間の短縮を実現~












