解析事例
温度サイクル試験によるはんだ接合部のき裂進展解析
こんな方におすすめ
- チップ接合部の温度サイクル試験をシミュレーションしたい。
- き裂進展の進行方向や分布などをシミュレーションで確認したい。
半導体チップの高密度化に対応するため、実装密度の高いBGA(Ball Grid Array)による接合方法を採用するケースが多くなっております。ただ、この方法の場合、接合部の一部に局所的な応力が発生することが知られており、ある程度の信頼性を見積もっておく必要があります。
従来どおり温度サイクル試験で信頼性評価を調査することも必要ですが、シミュレーションを活用することで短期間にその傾向を掴むことが可能です。
図に示すようなメッシュまで作成した形状モデルをご用意いただければ、Ansys Mechanical APDL専用に作成したき裂進展マクロをご利用いただくことで、自動的に温度サイクル荷重を載荷した解析を実行します。その上で非線形ひずみ振幅を自動的に抽出し、各要素でManson-Coffin 則とマイナー則を適用し、温度サイクルにおける寿命を算出したり、き裂進展の様子を確認することが可能です。
本シミュレーションの場合、次のような手順で疲労寿命を算出します。
- 指定した回数の温度サイクル荷重を専用マクロで実行します。
- き裂進展の様子を確認します。
- き裂進展の状況からパスライン(き裂経路)を設定します。
- ポスト処理でき裂経路による疲労寿命を算出します。
※以下の解析事例もあわせてご参照下さい。
はんだの濡れ上がり解析
はんだの濡れ上がり形状を使用したクリープ解析
解析モデル
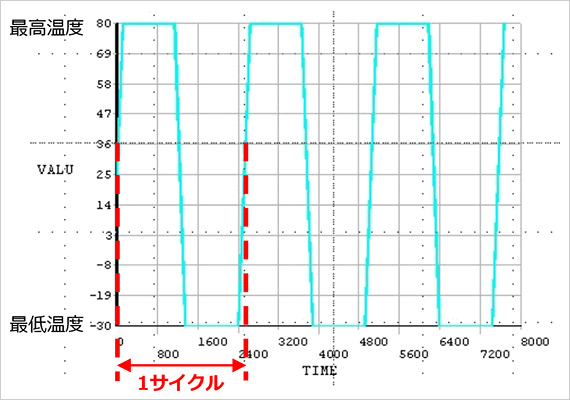
図 熱サイクル(時間vs温度)
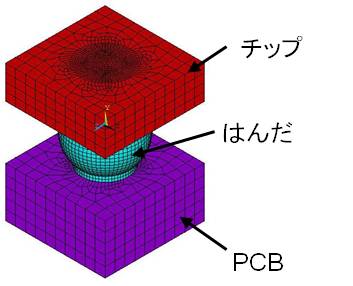
図 BGAモデル

図 はんだボールのき裂進展
解析結果
関連キーワード
関連情報
関連する解析事例
MORE関連する資料ダウンロード
MORE-
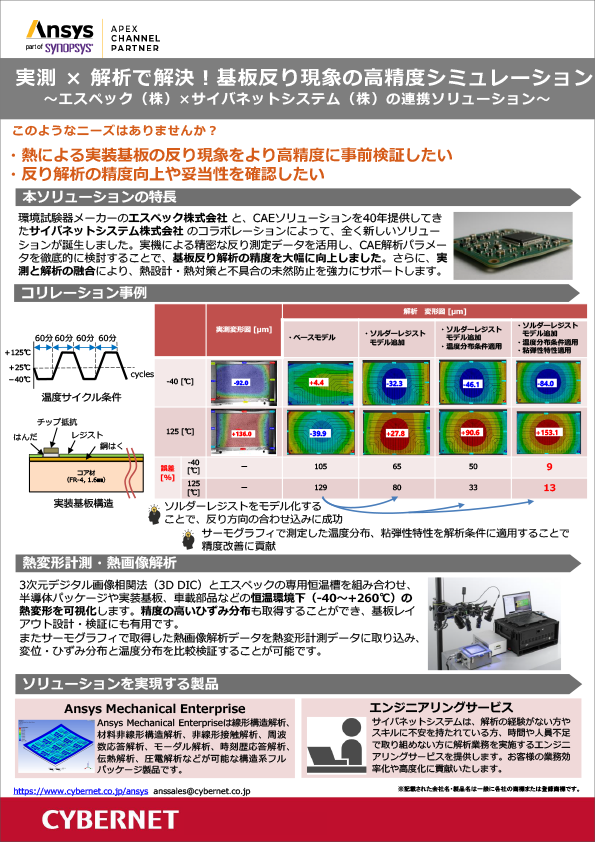
実測 × 解析で基板の熱変形問題を解決!基板反り現象の高精度シミュレーション
~エスペック(株)×サイバネットシステム(株)の連携ソリューション~
-

【全記事】CAEのあるものづくり vol.42
ユーザー様インタビュー記事7件を1冊に集約した保存版
-

誤差との上手なつきあい方 ~流体解析の計算誤差~ (完全保存版)
誤差との上手なつきあい方 前編・後編 を1冊にまとめた保存版 PDF
-

非線形解析の最大強度評価はAnsys LS-DYNAで解決!
~Ansys LS-DYNAで解決!最大荷重評価のボトルネック~
-

事例でご紹介!流体解析分野のエンジニアリングサービス ~解析業務の委託・立ち上げ支援・カスタマイズによる効率化など~
-
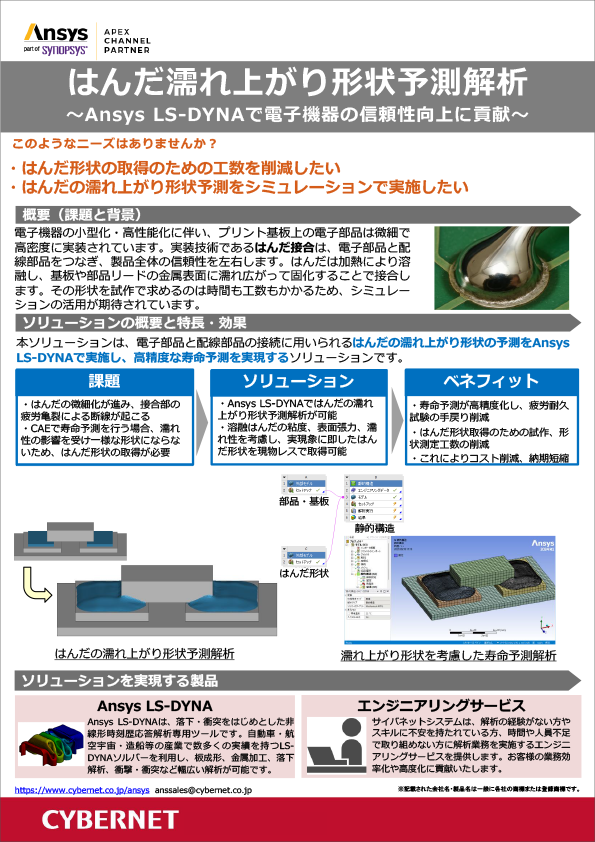
はんだ濡れ上がり形状予測解析で電子機器の信頼性向上
~Ansys LS-DYNAで電子機器の信頼性向上に貢献~
-

Ansys ユーザーのための PyAnsys 完全ガイド
Pythonで加速するCAEワークフロー
-

共振回避だけで終わらせない振動解析の進め方を解説(周波数応答・時刻歴まで)
~Ansys Mechanicalで実現する高度な製品開発~