資料ダウンロード
DIC計測装置を用いた解析精度向上へのアプローチ
日本アイ・ビー・エム株式会社 マイクロエレクトロニクス 西尾俊彦様、葛野正典様 エレクトロニクス・コンポーネント 岡本圭司様

CAEのあるものづくり Vol.12|公開日:2010年4月
目次
- はじめに
- 計測装置について
- 対象とするパッケージ
- パッケージ基板の材料特性の測定
- シミュレーションと実測との比較検証
- まとめ
はじめに
半導体の集積度が進むと、トランジスターの動作遅延は小さくなりますが、微細化された配線による信号遅延が増します。その改善のためには層間絶縁材料の非誘電率を下げる必要があり、結果として次第に脆い材料特性になりつつあります。半導体を機能部品として使えるような形(以下“パッケージ”)にする製造過程において、外部応力により半導体にダメージを与えたり、そのダメージが後に自らの発熱による熱応力で疲労破壊するといった深刻な問題になってます。その一方で、デジタルカメラや携帯電話のような携帯機器の高機能化より、複数の半導体チップを狭いシステム空間に押し込めるために、パッケージは複雑な3次元構造が求められています。そんな背景の中でデザイン段階でのその熱応力解析は重要度を増しています。
パッケージの熱変形は、主に構成する材料間の線膨張係数(以下CTE)のミスマッチにより発生します。パッケージ製造工程では、常温から約260℃のまでの温度範囲が複数回与えられ、信頼性の確認テストでは一例として、-55℃から125℃などの温度範囲での冷熱サイクル評価が行われます。このような熱応力モデルにおいて、複合材料特性の取り扱いが解析精度を左右します。パッケージ内に用いられるプリント基板(以下基板)が最も取り扱いが難しい複合材料となり、いかに精度の良い材料特性を入力できるかが大きな課題です。
本稿では、予測の難しい基板の複合材料特性を精度の良い計測により把握した上で、モデルの精度を検証します。低温から幅広い範囲でのパッケージの熱環境を実現する恒温チャンバーを導入し、デジタル画像相関法(以下DIC: Digital Image Correlation)により基板のCTE及びパッケージの熱変形挙動を計測します。さらに弾性率及びポアソン比を、DICと引張試験装置からなるナノメカニカルテスター(以下NMT)により計測します。計測した複合材料特性を反映したモデルの結果とDICにより変形実測した結果との比較を通して精度向上への方策を検討します。
計測装置について
すでにこの分野におけるZ方向の変位計測装置の代表としてはモアレ干渉法とレーザー法があります。モアレ干渉法は平坦な部品のZ方向の変位を計測する方法としては実績がありますが、立体的な複雑な形状計測には限界があります。又レーザー法はスキャンを行う間に温度変化があった場合など、時間と共に状態変化がある時には不向きです。今回適用したDICは、これらの欠点を克服するのに加えてZ方向以外にXY方向の変位も計測できます。この機能によりパッケージのCTEの計測も可能になります。さらに、引張試験装置を恒温チャンバーに入れ、DICにより弾性率に加えてポアソン比を実測する事も可能になります。
パッケージの線膨張係数及び変形計測装置の概要を図1に示します。構成は主に2台のCCDカメラ、-60℃~260℃まで温度コントロール可能な恒温チャンバー、画像処理用のPCから構成されます。
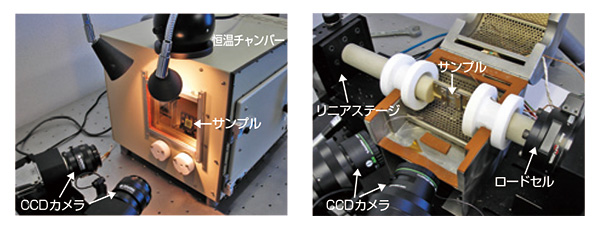 図1 計測装置の構成(左) 図2 NMT(右)
図1 計測装置の構成(左) 図2 NMT(右)DICとは、CCDカメラによって撮影された変形前の画像と変形後の画像を比較することで、サンプル表面での任意の点の変位を計測する手法です。また、2つのカメラ画像から得られる視差を利用することで、XY方向だけでなく、Z方向の変位を計測することができます。パッケージの変形は材料間の線膨張係数の差が主な原因ですので、測定対象の温度を均一にする事は最も重要です。赤外線ヒーターやホットプレートによる加熱の場合、構造上加熱側のサンプル表面温度とその裏面との温度差が異なる場合があり、温度勾配による熱変形を排除できません。今回導入した雰囲気加熱の恒温チャンバーはチャンバーサイズと雰囲気加熱用ヒーターの容量の最適化を計り、外形10から50mmのパッケージに対してサンプル内の温度差を均一にするために十分な熱容量を持ちながら、かつ容易に設定温度変化を可能にします。
NMTを図2に示します。これはロードセルとリニアステージを恒温チャンバーに入れた引張試験装置です。チャンバ部は-60℃~260℃まで温度コントロール可能で、サンプル設置ホルダーを覆う2重ガラスの断熱窓からサンプルのひずみをDICにより計測します。
X方向とY方向のひずみを同時に測定できますので、ポアソン比も得られるわけです。ロードセルの計測最大荷重は、50Nであり、リニアステージの分解能は10nm、最大25mmまで移動できます。
対象とするパッケージ
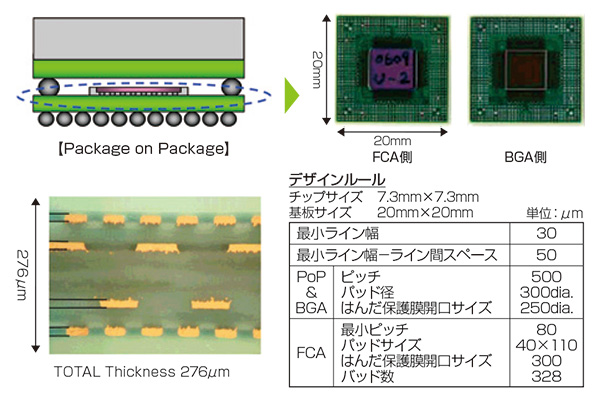 図3 PoP用パッケージ
図3 PoP用パッケージデジタルカメラや携帯電話の分野において、画像処理やWEBデータの処理などの演算を行うために、ロジック半導体チップとメモリー半導体チップのパッケージを積層するパッケージ・オン・パッケージ(以下PoP)と呼ばれるパッケージ構造が高密度化の代表的な構造です。全体での熱変形を正しく解析できる事を目指しますが、精度を落としている要因を明らかにするために、今回はそのロジック半導体の部分のみ着目し、先に紹介した計測装置類を使って、モデルの精度検証を行ってみます。パッケージの構造を図3に示します。シリコンチップ(7.3×7.3×0.725 mm)、封止樹脂、パッケージ基板(20.0×20.0×0.306 mm)で構成されています。
モデリングの際、チップや封止樹脂といった単一の材料に関しては材料メーカーから入手できたり、従来方法で計測した材料特性で十分に対応できます。基板は、各配線層の配線パターンが絶縁材料としての樹脂との複合材料となっており、さらに絶縁層では層間の配線を接続するビアと樹脂、さらにガラス繊維との複合材料となっています。
基板はアプリケーション毎に異なるデザインとなりますので、デザインパターンを考慮した材料特性の複合材料計算方法が必要になります。このパッケージの基板の複合材料特性をDIC及びNMTにより計測し…
関連情報
関連する解析事例
MORE関連する資料ダウンロード
MORE-
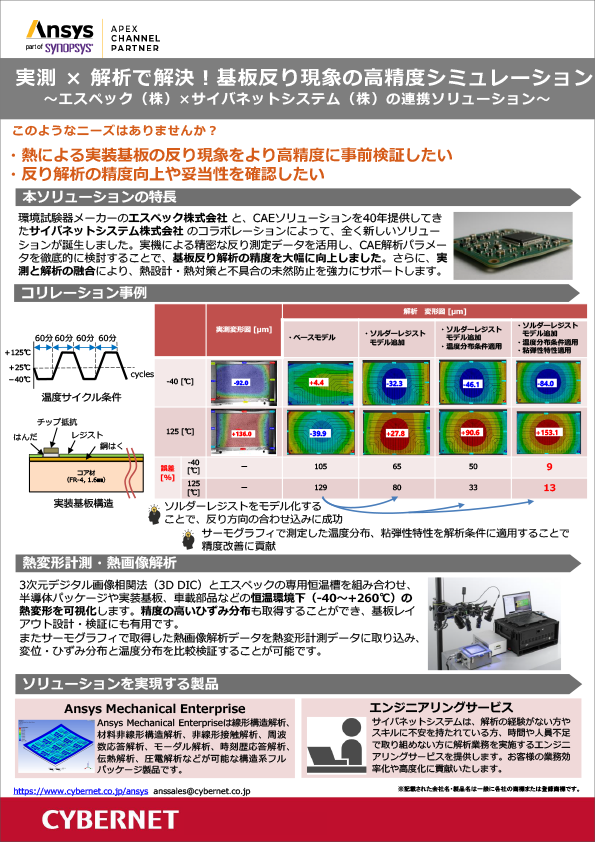
実測 × 解析で基板の熱変形問題を解決!基板反り現象の高精度シミュレーション
~エスペック(株)×サイバネットシステム(株)の連携ソリューション~
-

【全記事】CAEのあるものづくり vol.42
ユーザー様インタビュー記事7件を1冊に集約した保存版
-

誤差との上手なつきあい方 ~流体解析の計算誤差~ (完全保存版)
誤差との上手なつきあい方 前編・後編 を1冊にまとめた保存版 PDF
-

非線形解析の最大強度評価はAnsys LS-DYNAで解決!
~Ansys LS-DYNAで解決!最大荷重評価のボトルネック~
-

事例でご紹介!流体解析分野のエンジニアリングサービス ~解析業務の委託・立ち上げ支援・カスタマイズによる効率化など~
-
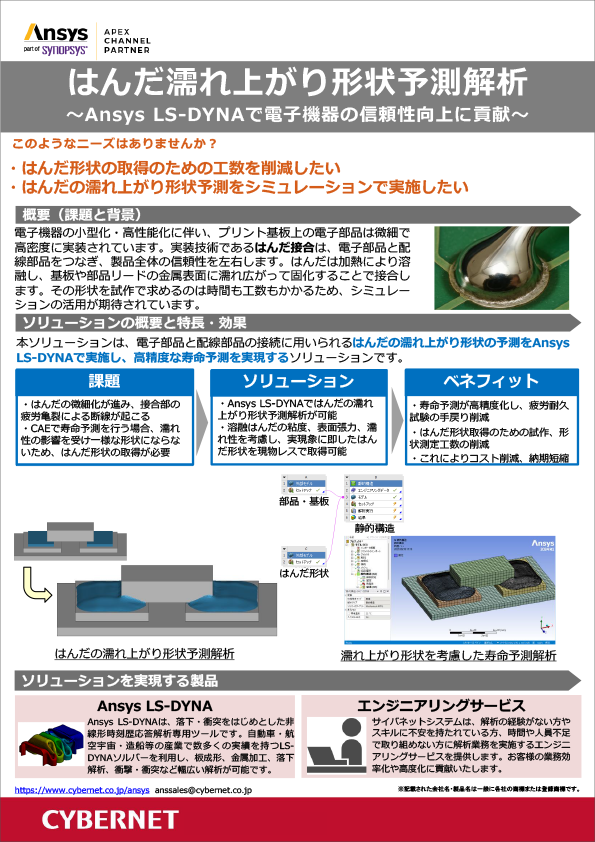
はんだ濡れ上がり形状予測解析で電子機器の信頼性向上
~Ansys LS-DYNAで電子機器の信頼性向上に貢献~
-

Ansys ユーザーのための PyAnsys 完全ガイド
Pythonで加速するCAEワークフロー
-

共振回避だけで終わらせない振動解析の進め方を解説(周波数応答・時刻歴まで)
~Ansys Mechanicalで実現する高度な製品開発~