解析事例
ICパッケージ内のワイヤースイープ解析
こんな方におすすめ
- ICパッケージを設計する際に、予めボンディングワイヤーのスイープを把握して設計を行いたい。
- ICパッケージ製造工程において、ボンディングワイヤーの変位に起因する不良が発生している。そのため樹脂流動を考慮したワイヤースイープ解析を利用して、不良の発生しない成形条件を検討したい。
ICパッケージのトランスファー成形における樹脂流動を解析し、その結果得られるストークス抵抗をボンディングワイヤーへの荷重として与え、ワイヤーの変形について検討しました。
ICパッケージは、タブレットと呼ばれる成形素材(熱硬化性樹脂)をプランジャーで押すことによってキャビティ内に移送するトランスファー成形が主流となっています。成形中には樹脂の流れの影響により、ICパッケージ内に配置されているリードフレーム、パッド、及びボンディングワイヤーなどに力が掛かり、それら部品に変形が生じます。今回は、このボンディングワイヤーの変形についての解析事例をご紹介します。
ボンディングワイヤーは、ICパッケージにおいて信号を伝える重要な役目を持っています。樹脂から受ける力が過大な場合には、ワイヤーが過剰に変形したり変位を起こしたりする可能性があります。特に変位(ワイヤースイープ)が大きいとワイヤー同士が接触する可能性が高くなり、正しく信号が伝わらないといった不具合が発生することになります。またボンディングワイヤーは素材が展性・延性に富む金であるため、変形の際に回復しない塑性変形が生じる恐れもあり、塑性変形を定量化することもICパッケージ設計には重要と思われます。
Ansys Workbench版 射出成形CAEシステム「PlanetsⅩ」は、ワイヤースイープを弾性変形と塑性変形に分けて検討できます。またトランスファー成形機能、リードフレーム・パッド変形解析機能と合わせて、トータルでICパッケージの設計やトラブルシューティングが可能です。
解析モデル
解析結果
図.ワイヤー変形(アニメーション)
図.ワイヤー変形(アニメーション・拡大図)
関連キーワード
関連情報
関連する解析事例
MORE関連する資料ダウンロード
MORE-
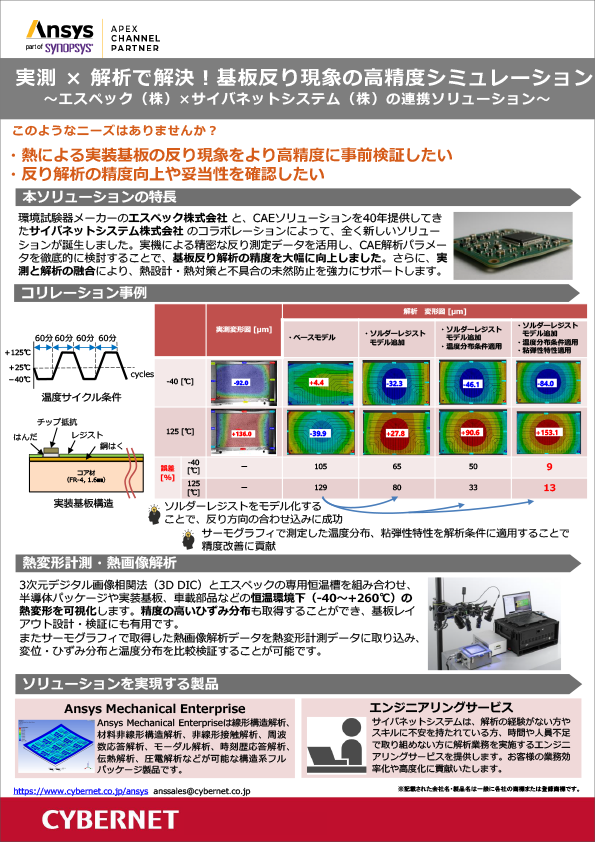
実測 × 解析で基板の熱変形問題を解決!基板反り現象の高精度シミュレーション
~エスペック(株)×サイバネットシステム(株)の連携ソリューション~
-

【全記事】CAEのあるものづくり vol.42
ユーザー様インタビュー記事7件を1冊に集約した保存版
-

誤差との上手なつきあい方 ~流体解析の計算誤差~ (完全保存版)
誤差との上手なつきあい方 前編・後編 を1冊にまとめた保存版 PDF
-

非線形解析の最大強度評価はAnsys LS-DYNAで解決!
~Ansys LS-DYNAで解決!最大荷重評価のボトルネック~
-

事例でご紹介!流体解析分野のエンジニアリングサービス ~解析業務の委託・立ち上げ支援・カスタマイズによる効率化など~
-
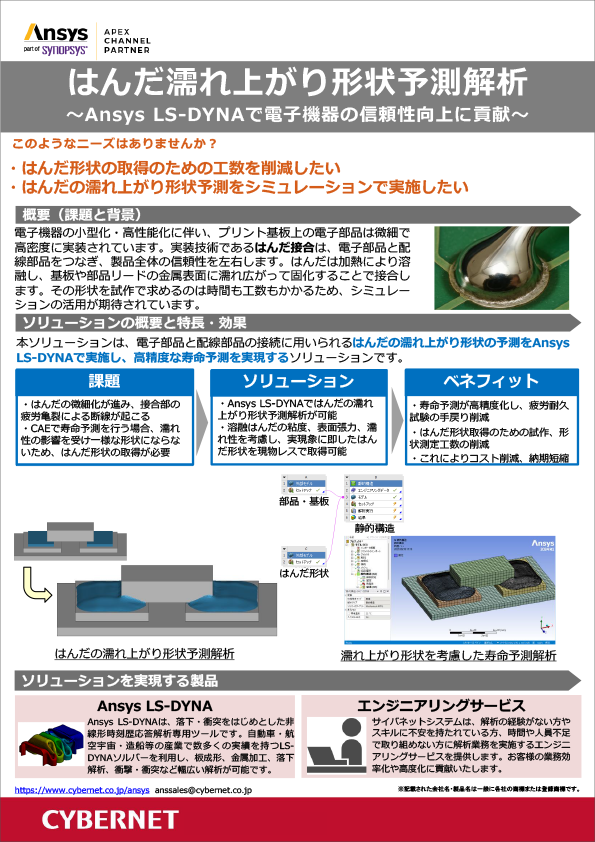
はんだ濡れ上がり形状予測解析で電子機器の信頼性向上
~Ansys LS-DYNAで電子機器の信頼性向上に貢献~
-

Ansys ユーザーのための PyAnsys 完全ガイド
Pythonで加速するCAEワークフロー
-

共振回避だけで終わらせない振動解析の進め方を解説(周波数応答・時刻歴まで)
~Ansys Mechanicalで実現する高度な製品開発~