解析事例
光半導体パッケージの反り解析
(情報提供:浜松ホトニクス株式会社様)
背景
本PKGにおいて、組立後の基板反りが問題となっている。現状の反り量は65 〜 70um。形状は山反り。
Ansysを用いて、現状より反りの少ないPKG形状を検討する。
検討内容
本解析で形状を変更していく項目を以下にあげる。
- 基板材料
- 基板厚
- 樹脂硬化温度
材料
本解析にて使用した材料
- ガラエポ基板A(リファレンス FR4相当)
- ガラエポ基板B(高弾性/低熱膨張)
- セラミック基板
- シリコンチップ
- ダイボンド樹脂
- 保護樹
組立工程フロー
解析で使用する現行製品の組立工程を以下にまとめる。
解析モデル
作成した解析モデルを以下に示す。 解析モデルは、製品の4分の1の対称モデルである。
解析条件
今回の解析では、以下9条件で解析を行った。
解析条件①… 現行PKGモデルそのままで解析
解析条件②… 基板厚みを0.5倍へ変更
解析条件③… 基板厚みを1.5倍へ変更
解析条件④… ダイボンド樹脂硬化温度変更 : 150℃→25℃
解析条件⑤… ダイボンド樹脂硬化温度変更 : 150℃→80℃
解析条件⑥… 基板材料変更 :熱膨張係数の小さい基板Bへ変更
解析条件⑦… ダイボンド樹脂硬化温度80℃+熱膨張の小さい基板B
解析条件⑧… ダイボンド樹脂硬化温度80℃+熱膨張係数の小さい基板B+基板厚み1.5倍
解析条件⑨… 基板をセラミックへ変更
(※硬化後のダイボンド樹脂は軟化しないと仮定)
解析結果
各条件における解析結果を以下にまとめる。結果は、チップのZ方向の反り量を表示。
考察
現行製品の反りが65 〜 70um反っているのに対し、本解析では66.8umの反りという結果となり、信頼できる解析と考える。
上表より、ダイボンド樹脂硬化後、山反り方向に反りが発生している。ダイボンド樹脂と基板の熱収縮のほうがチップより大きいことから、全体としては山反りになることが考えられるため、この解析結果は妥当と言える。
また、反りはダイボンド樹脂硬化後に最大になるが、ポッティング樹脂硬化により反りが改善される方向に変化することが分かる。保護樹脂は熱収縮が大きく谷反り方向に反ることが考えられる。よって全体としてみると、ダイボンド樹脂硬化で発生した反りを改善する方向に力が発生し、結果反りが改善されたと考えられる。
今回の評価では現行条件を含め計9条件のモデルを考えそれぞれの反り量を解析した。その中でも容易に反り改善が期待できるのは、解析条件⑤だと考えられる。さらに反り改善が必要となる際は、解析条件⑧(若しくは⑦)を適用することで最も反り量を低減できると考えられる。
関連キーワード
関連情報
関連する解析事例
MORE関連する資料ダウンロード
MORE-
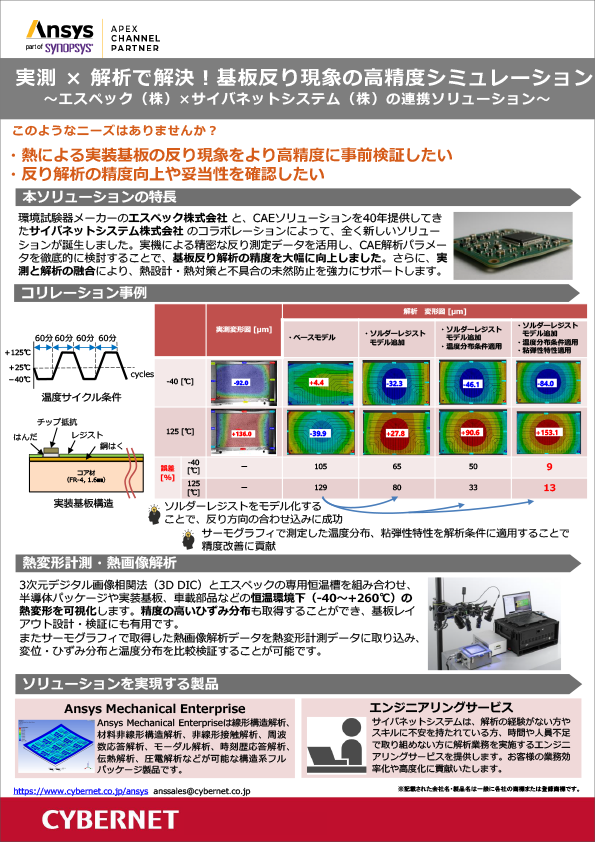
実測 × 解析で基板の熱変形問題を解決!基板反り現象の高精度シミュレーション
~エスペック(株)×サイバネットシステム(株)の連携ソリューション~
-

【全記事】CAEのあるものづくり vol.42
ユーザー様インタビュー記事7件を1冊に集約した保存版
-

誤差との上手なつきあい方 ~流体解析の計算誤差~ (完全保存版)
誤差との上手なつきあい方 前編・後編 を1冊にまとめた保存版 PDF
-

非線形解析の最大強度評価はAnsys LS-DYNAで解決!
~Ansys LS-DYNAで解決!最大荷重評価のボトルネック~
-

事例でご紹介!流体解析分野のエンジニアリングサービス ~解析業務の委託・立ち上げ支援・カスタマイズによる効率化など~
-
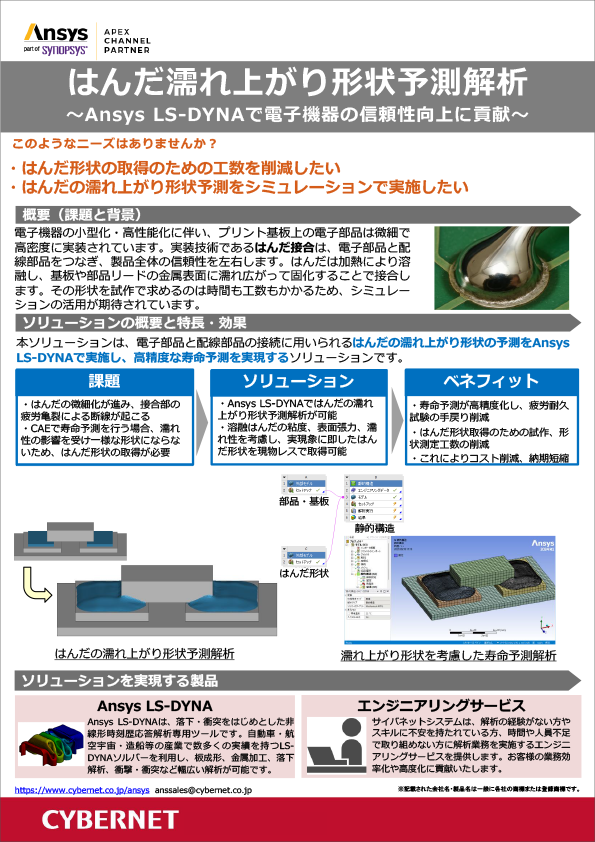
はんだ濡れ上がり形状予測解析で電子機器の信頼性向上
~Ansys LS-DYNAで電子機器の信頼性向上に貢献~
-

Ansys ユーザーのための PyAnsys 完全ガイド
Pythonで加速するCAEワークフロー
-

共振回避だけで終わらせない振動解析の進め方を解説(周波数応答・時刻歴まで)
~Ansys Mechanicalで実現する高度な製品開発~