製品情報
非接触分光膜厚測定器 Fシリーズ

光の干渉を利用した非接触膜厚測定システム。
用途に応じてマッピング測定や顕微領域測定など、幅広い測定方式に対応
用途に応じてマッピング測定や顕微領域測定など、幅広い測定方式に対応
Fシリーズは光の干渉を利用した反射率分光方式の非接触膜厚測定システムです。分光システムと高性能な膜厚解析ソフトウェアを組み合わせ、小型ながら高精度かつ短時間で測定できるように設計されています。
| 利用用途 |
|
|---|---|
| 測定項目 |
|
特長
コンパクトな測定システムで、マッピングや顕微測定など様々な測定方式に対応可能
光ファイバ―プローブを用いて試料表面の反射率を測定するため、様々な測定に対幅広く応可能です。シングルポイント測定のF20シリーズ、顕微鏡式測定のF40シリーズ、自動マッピング測定のF50,F60シリーズなど、様々な測定システムでニーズに対応します。
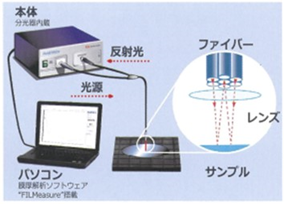
膜厚解析ソフトウェアFILMeasureにより簡易に解析が可能
光拡散シート表面(左)やカバーガラスの傷(右)のナノオーダの凹凸を測定。ワンショットで1㎜角エリアのナノオーダの凹凸形状を測定可能です。

測定事例
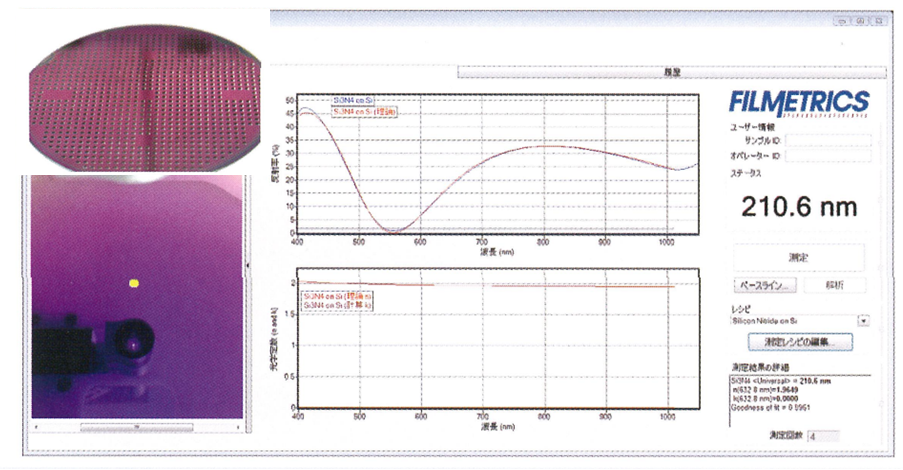
測定事例1:Si3N4の光学定数の測定
材料の屈折率や消衰係数は、材料によって異なり、また波長に依存して変化します。この変化の規則性は分散式で表されます。
例えばSi3N4は、シリコンと窒素の含有比によって、屈折率の特性が変わります。
FILMeasureには、Si3N4を測定する専用の分散式が用意され、簡単に測定が可能です。

測定事例2:レジスト膜の膜厚分布測定
レジスト膜は、一般的にスピンコーターやスリットコーター等でSiウェハ上に塗布されます。膜材料の特性や塗布条件によって、面内のレジスト膜の厚みは変化します。最適な塗布条件の管理の為に、面内分布を測定する事が必要不可欠です。
F50自動マッピング測定システムは、指定した測定箇所を自動で測定します。
多点の測定結果を基に2D、3D画像として表示するので、面内のレジスト膜の膜厚分布が簡単に確認できます。
